Videopräsentation des Beitrags
Rund 80 % des CO2-Abdrucks durchschnittlicher Elektronikbauteile entsteht bereits bei der Produktion. Ein Forschungsteam des Fraunhofer EMFT arbeitet daran, Prozesse in der Halbleiterfertigung zu optimieren, um den Einsatz klimaschädlicher Prozessgase zu minimieren. Dabei testen die Wissenschaftlerinnen und Wissenschaftler auch klimafreundlichere Alternativen zu bislang standardmäßig eingesetzten Ätzgasen.

Ein Beitrag von Robert Wieland
Fraunhofer-Institut für Elektronische Mikrosysteme und Festkörper-Technologien (EMFT)
Auch Elektronikprodukte schleppen einen ökologischen Rucksack mit sich herum – das ist heute allgemein bekannt. Was jedoch vielleicht überraschen mag: Der Löwenanteil des CO2-Ausstoßes eines Produkts, rund 80%, entfallen nicht etwa auf die Nutzungsphase, sondern entstehen bereits bei der Produktion.
Warum ist das so?
Das zeigt sich eindrücklich am Beispiel der Halbleiterfertigung. Das so genannte Tiefenätzen ist in dem Bereich ein zentraler Basisprozess, um in einen Siliziumwafer Mikrostrukturen einzubringen. Dafür kommt bislang das äußerst klimaschädliche Gas Schwefelhexafluorid (SF6) zum Einsatz – ein Hauptgrund für die schlechte Ökobilanz.
Genau an diesem Punkt setzt ein Forschungsteam des Fraunhofer-Instituts für Elektronische Mikrosysteme und Festkörper-Technologien EMFT an: Sie wollen durch Optimierung des Technologieprozesses die Menge der benötigten Prozessmedien reduzieren. Zudem arbeiten sie an Alternativen zu dem schädlichen Fluorgas. Im Rahmen des BMBF-Projekts SUMSi entwickelt das Team zwei neuartige Plasmaquellen für das Tiefenätzen von Silizium, die deutlich kleinere Prozesskammern erlauben: eine so genannte INCA-Quelle – ein induktiv gekoppeltes Plasma-Array – sowie eine Mikrowellen-angeregte, flächige Plasmastab-Quelle.
Im Fokus der Entwicklungen stehen ein effizientes, flächen-skalierbares Plasmaquellenkonzept, ein schneller Gasaustausch beim Wechsel zwischen Passivierungsschritt und Ätzschritt, ein geringerer Prozessgasverbrauch durch einen besseren Zersetzungsgrad der Prozessgase und damit einhergehend eine geringere klimaschädliche Abgaslast.
Beide Varianten wurden während der nur 11-monatigen Entwicklungszeit bereits erfolgreich in der Plasmaätzkammer am Fraunhofer EMFT im so genannten „Boschprozess“ getestet. Das Verfahren basiert vereinfacht gesagt auf einem regelmäßigen Wechsel zwischen Passivierung und Si-Ätzen und wird in der industriellen Produktion standardmäßig zur Herstellung von Mikrostrukturen eingesetzt.
Die Wissenschaftler und Wissenschaftlerinnen nutzten dabei drei verschiedene Prozessmedien: C4F8 (Passivierungsgas), SF6 (klimaschädliches Ätzgas) sowie mit einer FAN-Gasmischung (klimafreundliches Ätzgas, Gemisch aus F2/Ar/N2). Die Ätzraten – also der Materialabtrag pro Zeit – war dabei mit SF6 vergleichbar oder sogar höher als bei derzeit eingesetzten Anlagen. Die klimafreundlicheren Alternativen liegen derzeit aufgrund der signifikant niedrigeren Fluor-Anteils noch darunter. Angesichts des enormen CO2-Einsparpotenzials steht für das Forschungsteam außer Frage, an dem Thema dranzubleiben:
Eine erste Abschätzung für das CO2-Equivalent des Boschprozesses mit SF6 für Si-Tiefenätzungen ergibt etwa 6.500t CO2-eq Ausstoß für den Betrieb einer kleineren MEMS-Fabrik. Zum Vergleich: Bei Verwendung alternativer, klimafreundlicherer Gase sänke der CO2-EQ um mehr als den Faktor 10 auf ca. 530t CO2-eq. Die Suche nach umweltfreundlicheren Prozess-Lösungen hat also gerade erst begonnen und wird am Fraunhofer EMFT im Rahmen der Initiative Green ICT intensiv weitergeführt.
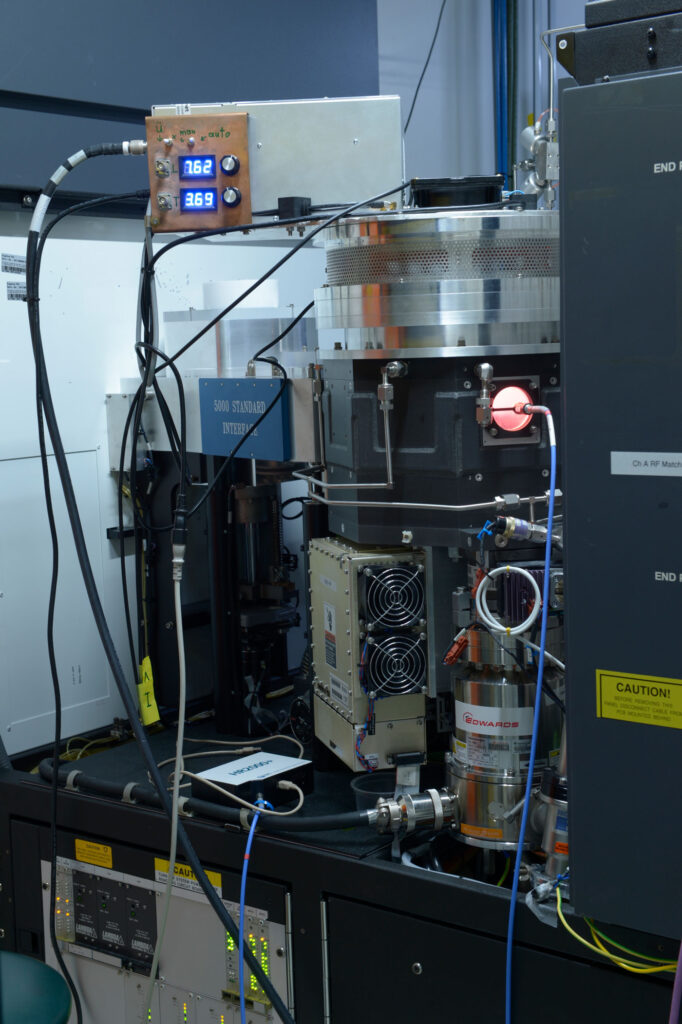
INCA-Plasmaquelle (Inductive Coupled Array) mit gezündetem Plasma – Fluor-Gasgemisch anstatt SF6. Die neu entwickelte INCA-Plasmaquelle besteht aus dem oberen Teil (blankes Al) inklusive automatischer Anpassungseinheit und wurde an eine am Fraunhofer EMFT schon vorhandene Plasmaätzkammer adaptiert. Die für N2 (Stickstoff) typische, rosa Plasmafarbe ergibt sich aus dem in der Fluorgasmischung enthaltenen N2.
